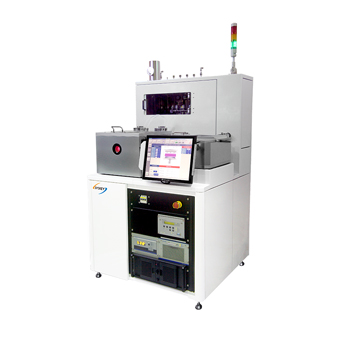
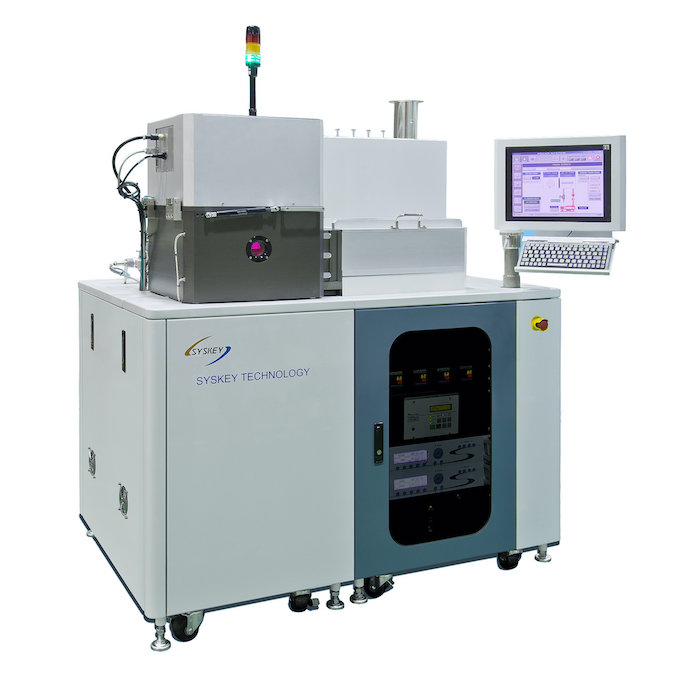
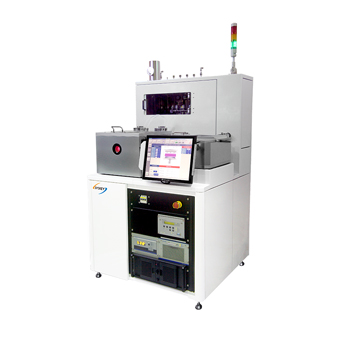
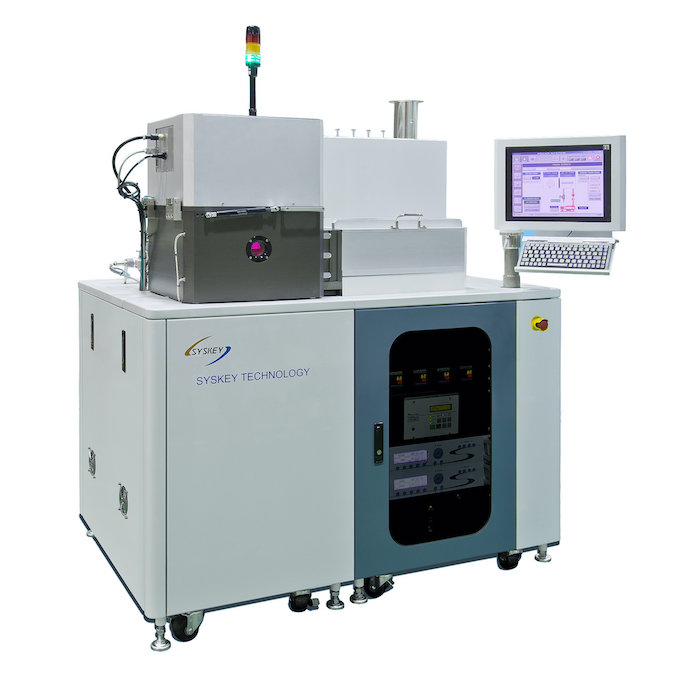
型号:RIE-SC4/6/8-A00 & ICP-SC4/6/8-A00
品牌:SYSKEY
分类:真空镀膜设备
简述:SYSKEY可提供反应离子刻蚀和电感耦合反应离子刻蚀,支持最大 8 英寸样品。
反应离子腐蚀
Reactive Ion Etching - RIE
技术是一种各向异性很强、选择性高的干法刻蚀技术。它是在真空系统中利用分子气体等离子来进行刻蚀的,利用了离子诱导化学反应来实现各向异性刻蚀,即是利用离子能量来使被刻蚀层的表面形成容易刻蚀的损伤层和促进化学反应,同时离子还可清除表面生成物以露出清洁的刻蚀表面的作用。
平行式RIE系统采用圆柱型真空内腔,衬底载台位于腔体底部且腔室电隔离。气体由腔室顶部进入,从底部被真空泵抽走。
电感耦合等离子体刻蚀
Inductively Coupled Plasma Reactive Ion Etching - ICPRIE
利用射频感应线圈产生气体等离子体。虽然蚀刻轮廓倾向于更加各向同性,但可以实现非常高的等离子体密度,其增加了蚀刻速率,且RF偏压被施加到衬底上产生的定向电场可以实现更多的各向异性蚀刻轮廓。
刻蚀所用气体的类型和数量取决于蚀刻材料和工艺;例如,SF6 通常用于 Si 的刻蚀,CF4 常用于石英材料刻蚀,Cl2 常用于金属材料刻蚀。通过腔体内的工作压力由流量计和蝶阀协同控制,工艺压力通常在几毫托和几百毫托之间。
RIE和ICPRIE被广泛应用于微纳加工技术中,根据被刻蚀材料可简单分类为:
● 介质刻蚀:SiO2,Si3N4,Al2O3等
● IV族半导体刻蚀:Si,Ge
● III-V族半导体刻蚀:GaN,GaP,GaAs等
● II-VI族半导体刻蚀:InSb等
● 金属刻蚀:Cu,Al,Au等
配置特点:
● 样品尺寸:6寸、8寸、12寸
● 本底真空优于 5 × 10-3 Torr
● 前驱工艺气体:最多 9 路工艺气体,根据刻蚀种类选择
● 蝶阀全自动压力控制
● 前驱物加热与冷却功能可选,且可替换
● 300W/600W/1000W ICP 等离子体模块,300W/600W下电极射频电源
● 刻蚀均匀性优于5%
地址
上海市嘉定区皇庆路333号3幢北楼3层
手机
15618100191(于经理)
13524020642(刘经理)
电话
021-61314745
邮箱
sales@dezisemi.com

关注微信公众号