



型号:SI 500 D
品牌:SENTECH
分类:化学气相沉积
简述:SI 500 D 是基于平行板三螺旋天线(PTSA)设计的平行板电极式电感耦合等离子体化学气相沉积(ICP-CVD)设备,PTSA射频等离子体源可有效地提高等离子体的密度,达到低功率,高密度,低温,低损伤的工艺效果。
电感耦合等离子体化学气相沉积
Inductively Coupled Plasma Chemical Vapor Deposition - ICPCVD
SI 500 D ICP-CVD 使用平行板三螺旋天线(PTSA)设计,兼具平行板CCP和ICP两种射频源的特点,可实现低温低损伤低应力介质薄膜沉积。
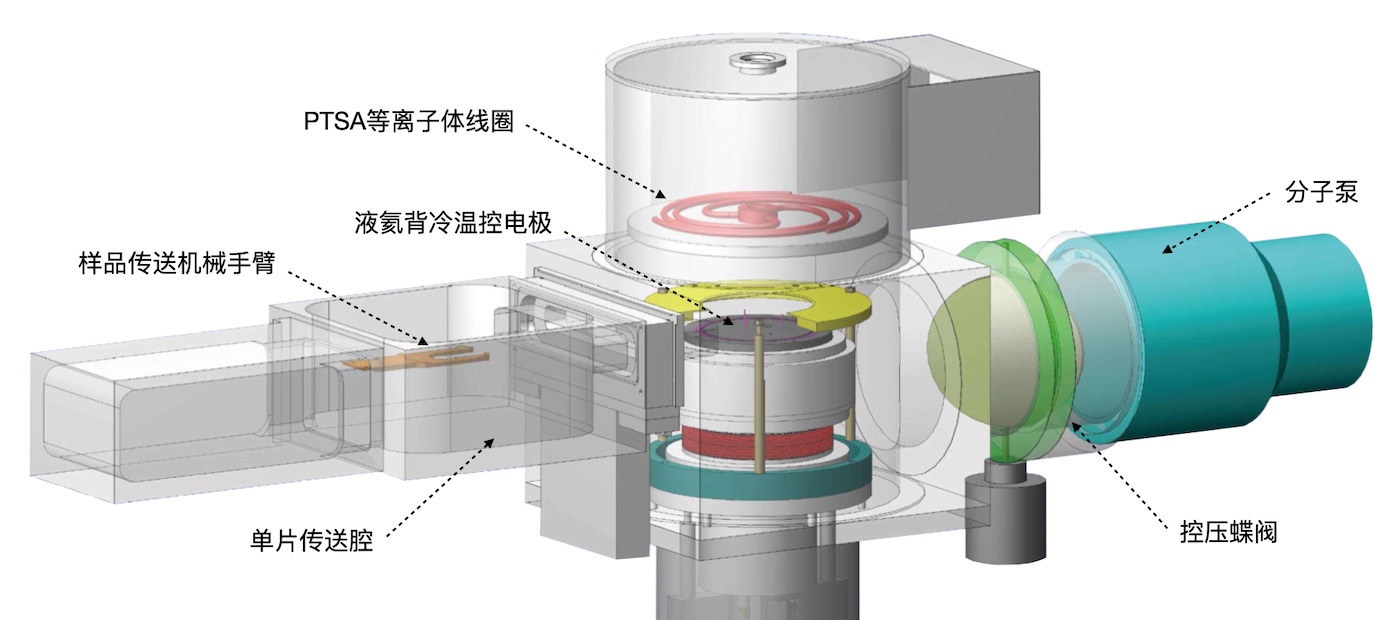
平行板三螺旋天线(PTSA)设计ICP-CVD
主要技术特点
● 高密度等离子体:具有优异的等离子体特性,如高密度,低离子能量和低压等离子体。
● 低功率耦合:SENTECH 的平行板三螺旋天线 (PTSA) 等离子体源专利技术,实现低功率耦合。
● 低温等离子体:低刻蚀速率、高击穿电压、低应力、不损伤衬底,以及在低于 100°C 的沉积温度下的低界面态密度,使得所沉积的薄膜具有优异的性能。
● 动态温度控制:动态温度控制结合氦气背冷的衬底电极,衬底温度控制:室温到 +350°C 。
主要配置特点
● SI 500 D ICP-CVD 可沉积各种常见薄膜,如介质膜、α-Si、SiC 和其他材料。平行板三螺旋天线(PTSA)等离子体设计,独立的反应气体控制、动态温度控制衬底电极、全自动控制的高真空系统、采用远程现场总线技术的先进 SENTECH 控制系统,以及用户友好的软件界面。
● SI 500 D ICP-CVD 兼容各种各样的衬底,从直径 200 mm(8英寸) 的晶片到装载在载片器上的碎片。单晶片预真空室保证了稳定的工艺条件和人员的安全,并实现了不同工艺之间的快速便捷切换。
● SI 500 D ICP-CVD 可实现从室温到 350℃ 的温度范围内沉积 SiO2、SiNx、SiONx 和 α-Si 薄膜。可兼容液态或气态前驱体,可提供 TEOS, SiC 和其它特殊材料和前驱体的薄膜沉积提供全套解决方案。特别适用于在有机材料上低温沉积保护层和在既定的温度下无损伤地沉积钝化膜。
● SENTECH 提供不同级别的自动化程度,从真空片盒载片到一个工艺腔室或六个工艺模块端口,具有很高的升级灵活性或高产能拓展可能性。该系统可用作多腔系统中的一个工艺模块,直接集成于其中。
应用展示
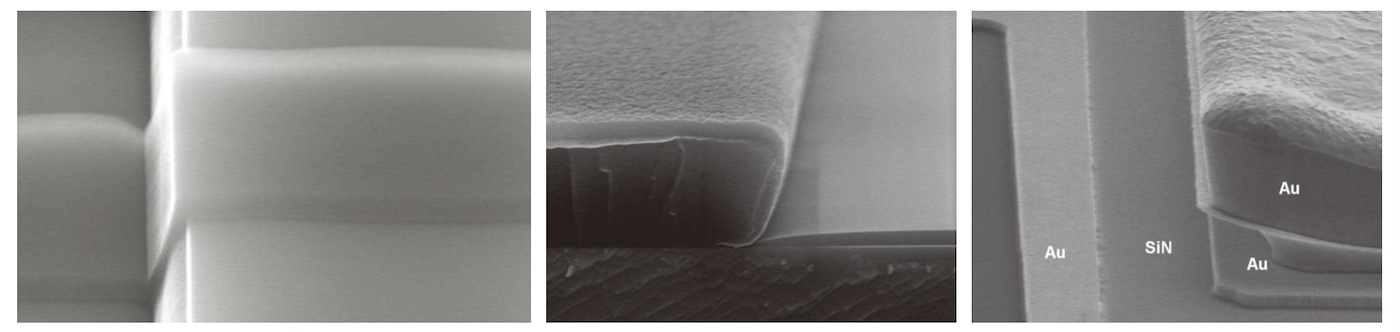
低温沉积,高台阶覆盖性,高致密度沉积
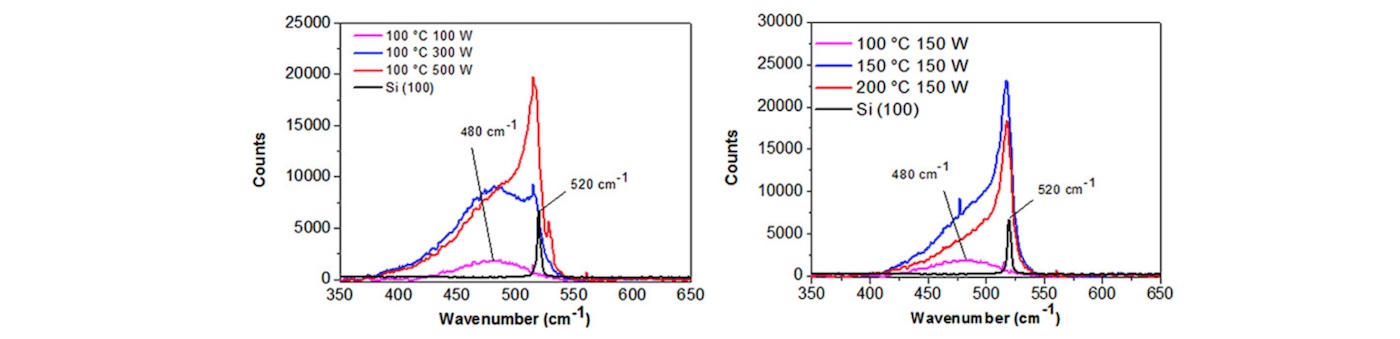
低温沉积Si薄膜拉曼谱
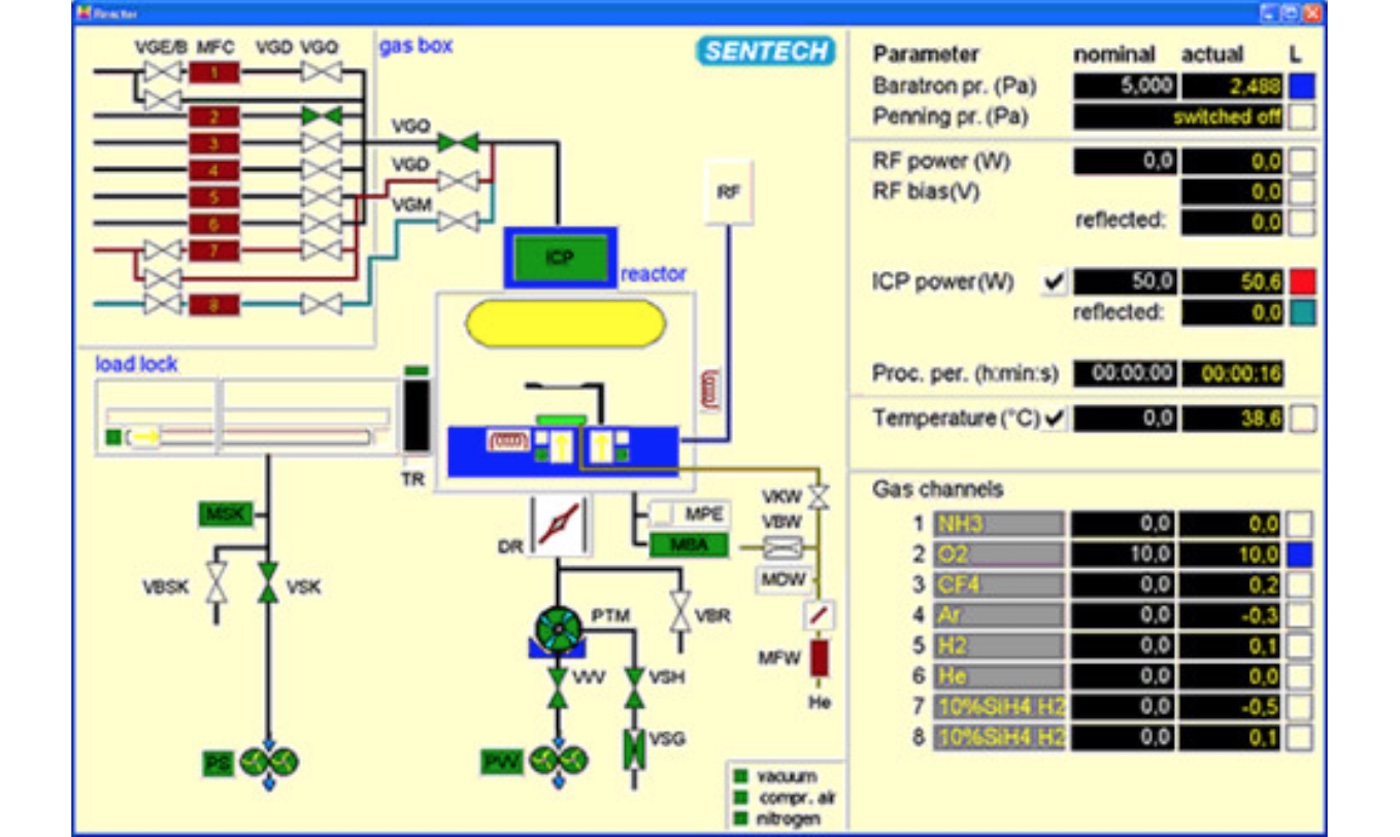
用户友好界面控制软件
SI 500 D 配置选择
● ICP-CVD 主机
● 单片预真空室
● 多片预真空室
● 适用于 200 mm(8英寸)的晶圆
● 衬底温度从室温到 350°C
● 激光终点检测
● 备选电极偏置
地址
上海市嘉定区皇庆路333号3幢北楼3层
手机
15618100191(于经理)
13524020642(刘经理)
电话
021-61314745
邮箱
sales@dezisemi.com

关注微信公众号